

点击参与:新思科技硬件加速验证技术日即将登陆成都、南京、杭州

近日韩国设备厂商拟断供 TC Bonder,严重影响中国 HBM 产业发展。
作为热压键合关键设备,其需求因 HBM 和 DDR5 推出而激增。韩国 HANMI Semiconductor 主导市场,供应 90% 的 HBM3E 12 级产品。TCB 技术优势显著,尽管有新技术探索,但实现国产迫在眉睫。
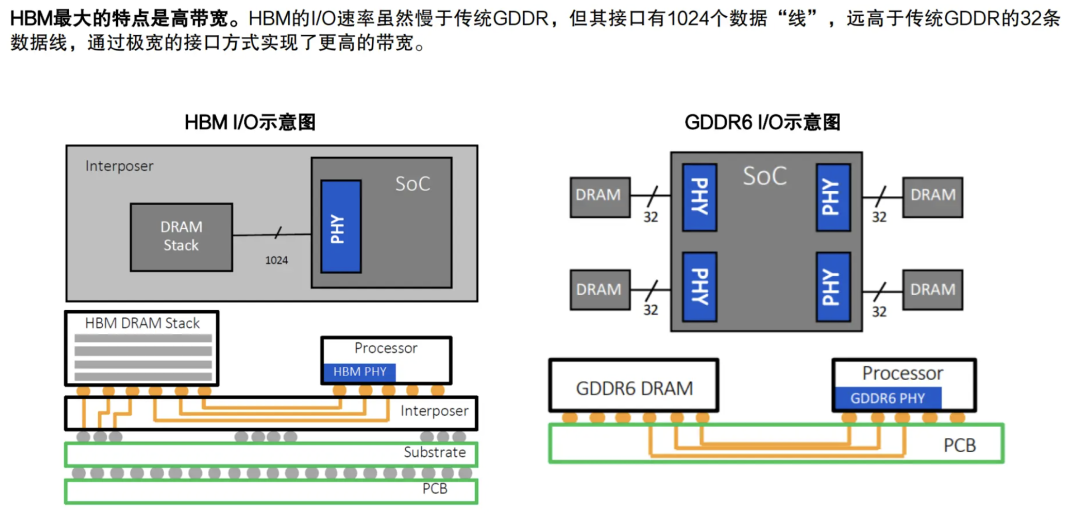
韩国厂商拟断供 TC Bonder,本土 HBM 面临挑战
近日,韩国设备厂商向中国厂商发出断供 TC Bonder 的通知,这一消息引发行业高度关注。随着高带宽内存(HBM)和 DDR5 技术的快速发展,TC Bonder 的市场需求持续攀升。摩根大通预测,HBM TC Bonder 市场规模将从 2024 年的 4.61 亿美元大幅增长,到 2027 年有望突破 15 亿美元,实现超两倍的扩张。
在全球 HBM TC Bonder 市场中,韩国 HANMI Semiconductor 占据主导地位,供应着 90% 的 HBM3E 12 级产品,服务对象包括 SK Hynix、Micron、Nvidia 和 Broadcom 等行业巨头。一旦断供成真,对于正大力发展 HBM 的中国本土产业而言,无疑是沉重打击,将严重阻碍相关产业的发展进程,凸显出国内加快自主研发的紧迫性。

韩美半导体第七座HBM TC Bonder工厂开工
TCB Bonder:HBM核心设备
TC Bonder,即负责热压键合(Thermocompression bonding,简称 TC bonding)工序的设备,在微电子和微系统工程中扮演着不可或缺的角色,主要用于将半导体芯片精准键合到基板或其他组件上。相较于标准倒装芯片工艺,TCB 技术展现出显著优势。
标准倒装芯片工艺存在热膨胀系数差异导致的翘曲、芯片间隙变化等缺陷,影响产品性能和稳定性。而 TCB 技术通过一台设备即可完成单个芯片的放置、加压和加热,实现焊球回流。其加热从芯片顶部进行,减少基板翘曲;施加压力确保键合均匀,消除间隙变化和倾斜问题;压力伴随的快速振动还能破坏金属氧化,减少空洞和污染。
此外,TCB 在相同 IO 间距下能实现更佳电气性能,支持 IO 间距缩小,助力打造更薄的芯片和封装,这正是 HBM 选择 TCB 技术的关键所在。尽管行业已在探索 TCB 的继任者,但目前来看,TC Bonder 的地位依旧难以撼动,其重要性不言而喻。
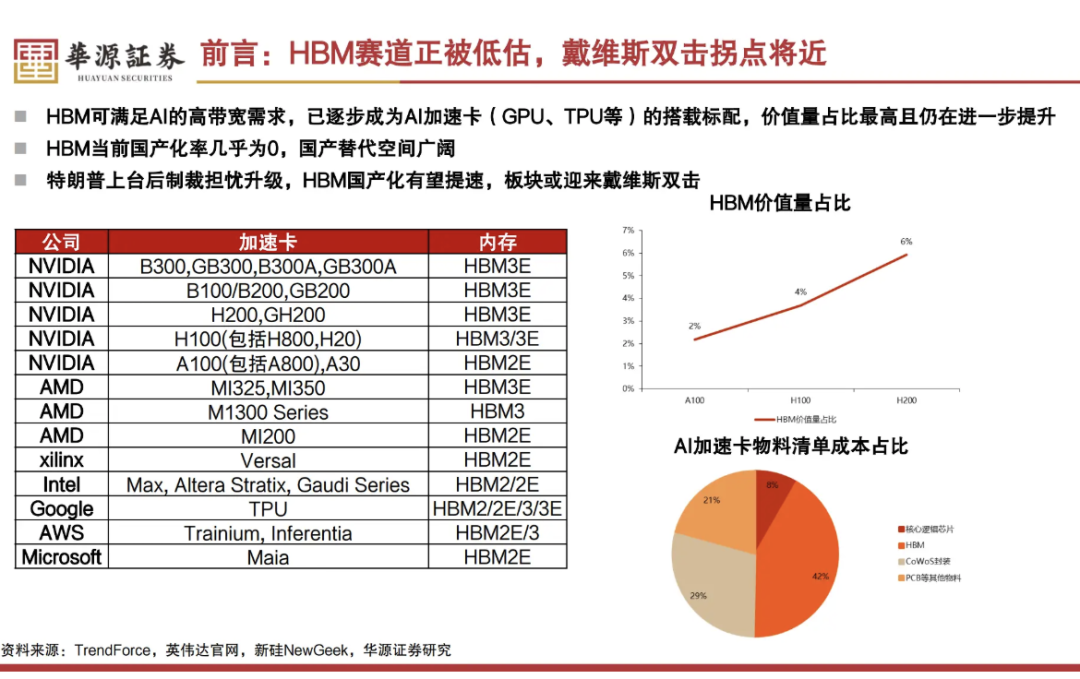
【扫码报名】新思科技硬件加速验证技术日即将登陆成都、南京、杭州
(来源:芯榜科技的财富号 2025-05-09 20:21) [点击查看原文]

